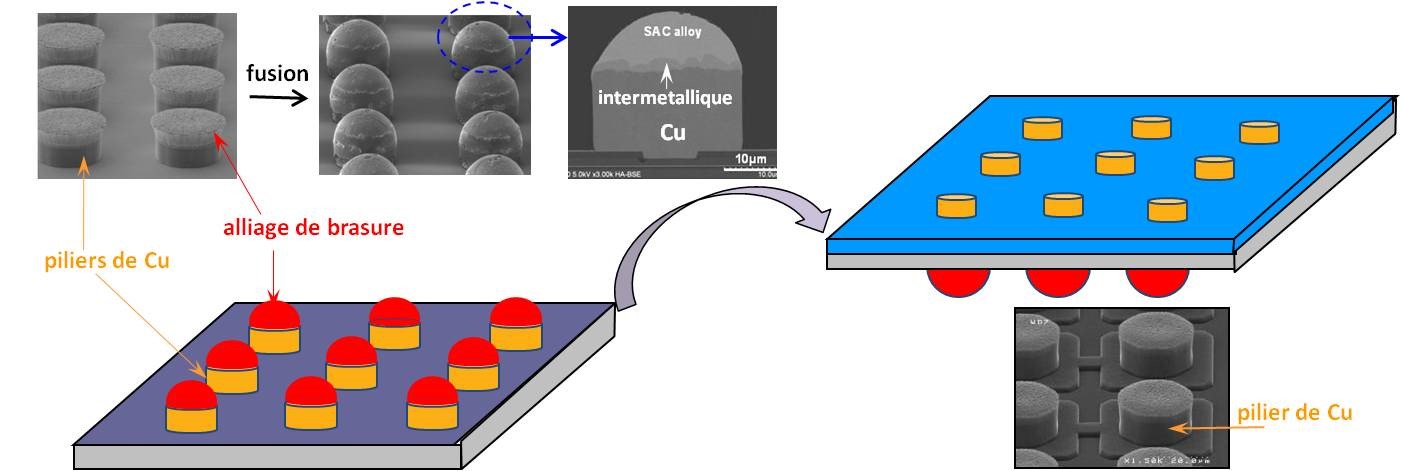
Application à l'assemblage de matériaux par brasage

Images de microscopie électronique de l’interface Cu/Sn liquide metastable (a) et Cu/Sn solide (b) après un maintien isotherme de 32h à 222°C. Modélisation de la croissance anormale de la phase Cu6Sn5 à l’interface Cu/Sn liquide via des canaux cylindriques de liquide de diamètre d formés aux joints triples des grains de Cu6Sn5 de diamètre D (c, d).
- Recherche d’alliages de brasure pour l’assemblage homogène métal/métal pour des applications à hautes températures (température de fusion autour de 450°C) compatible avec les procédés utilisés en microélectronique. Thèse de V. Lumineau, coll. CEA Leti, Grenoble (Outstanding StudentPaper Award à la conférence internationale PRIME 2016).
- Recherche d’alliages de brasure pour l’assemblage hétérogène métal/carbone pour des applications à basses températures (température de fusion inférieure à 800°C). Thèse de M. Tazi, coll. CEA Liten, Grenoble.
- Etude de l’évolution de la morphologie de l’interface pendant le soudage diffusion et le brasage du couple alliage de zirconium Zy4/acier inoxydable 304L. Thèse d’A. Lebaili, coll. Université d’Alger.
----------------------------------------------------------------------------------------------------------------------------------------------
Permanent: Fiqiri Hodaj
Doctorants: J. Bertheau, O. Liashenko, D. Taneya, V. Lumineau, M. Tazi, A. Lebaili
Collaboration: Laboratoire de Conception et Assemblages (LCA) du CEA Liten, le Laboratoire Packaging et Assemblage (LPA) du CEA Leti, STMicroelectronics Grenoble, Université de Cherkasy, Ukraine et Université d’Alger (Algérie)
----------------------------------------------------------------------------------------------------------------------------------------------
Journaux internationaux à comité de lecture:
A. Garnier, X. Baillin, F. Hodaj. Solidification and interfacial interactions in gold-tin system during eutectic or thermo-compression bonding for 200mm MEMS wafer level hermetic packaging. Journal of Materials Science - Materials in Electronics, vol. 24, p. 5000-5013, 2013
C. Lejuste, F. Hodaj, L. Petit. Solid state interaction between a Sn-Ag-Cu-In solder alloy and Cu Substrate. Intermetallics, vol. 36, p. 102-108, 2013
F. Hodaj, L. Petit, L. Baggetto, O. Boisier, L. Verneyre. Undercooling of Sn-Ag-Cu alloys: solder balls and solder joints solidification. International Journal of Materials Research, vol. 104, p. 874-878, 2013
F. Hodaj, A.M. Gusak, O. Liashenko. Possibility of shape phase transition for solidification of tin at the scallop-like surface of Cu6Sn5 compound. Philosophical Magazine Letters, vol. 93, p. 166-173, 2013
J. Bertheau, P. Bleuet, F. Hodaj, P. Cloetens, N. Martin, J. Charbonnier, N. Hotellier. Reflow processes in micro-bumps studied by synchrotron X-ray projection nanotomography. Microelectronic Engineering, vol. 113, p. 123-129, 2014
J. Bertheau, F. Hodaj; N. Hotellier, J. Charbonnier. Effect of intermetallic compounds thickness on shear strength of 25?m diameter copper-pillars.. Intermetallics, vol. 51, p. 37-47, 2014
F. Hodaj, O. Liashenko, A.M.Gusak. Cu3Sn suppression criterion for solid copper - molten tin reaction
Philosophical Magazine Letters, vol. 94, p. 217-224, 2014
O. Liashenko, A. Gusak, F. Hodaj. Phase growth competition in solid/liquid reactions between Cu or. Cu3Sn compound and liquid tin-based solder. Journal of Materials Science - Materials in Electronics, vol. 25, p. 4664-4672, 2014
A. Garnier, X. Baillin, F. Hodaj. Interfacial reactions and diffusion path in gold–tin–nickel system during eutectic or thermo compression bonding for 200 mm MEMS wafer level hermetic packaging
Journal of Materials Science - Materials in Electronics, vol. 26, p. 3427-3439, 2015
A. Gusak, F. Hodaj, O. Liashenko. Criteria of kinetic suppression of lateral growth of intermediate phases. Philosophical Magazine Letters, vol. 95, p. 110-121, 2015
O. Liashenko, A. Gusak, F. Hodaj. Spectrum of heterogeneous nucleation modes in crystallization of Sn-0.7wt%Cu solder: experimental results versus theoretical model calculations. Journal of Materials Science - Materials in Electronics, vol. 26, p. 8464-8477, 2015
O. Y. Liashenko, F. Hodaj. Differences in the interfacial reaction between Cu substrate and metastable supercooled liquid Sn–Cu solder or solid Sn-Cu solder at 222°C: Experimental results versus theoretical model calculations Acta Materialia, vol. 99, p. 106-118, 2015
F. Battegay, F. Hodaj. The interaction between copper and TixNy at low temperature. Journal of Materials Science, Materials in Electronics, vol. 27, p. 1679-1692, 2016
O.Y. Liashenko, S. Lay, F. Hodaj. On the initial stages of phase formation at the solid Cu/liquid Sn-based solder interface. Acta Materialia, vol.117, p. 216-227, 2016
O.Y. Liashenko, F. Hodaj. Wetting and spreading kinetics of liquid Sn on Ag and Ag3Sn substrates. Scripta Materialia, vol. 127, p.24-28, 2017
J. Bertheau, P. Bleuet, R. Pantel, J. Charbonnier, F. Hodaj, P. Coudrain, N. Hotellier. Microstructural and morphological characterization of SnAgCu micro-bumps for integration in 3D interconnects. Proceedings of Electronic Components and Technology Conference ECTC, IEEE 63rd, Las-Vegas (USA), 28-31 May 2013, p. 1127-1132, 2013
P. Bleuet, G. Audoit, J. Bertheau et al. Synchrotron radiation-based characterization of interconnections in microelectronics: recent 3D results. Proceedings of SPIE, vol. 9212, article number: 92120D, 2014
D.Taneja, M.Volpert, G.Lasfargues, T.Catelain, D.Henry, F.Hodaj. Understanding the behavior of SnAg bumps at 10 ?m pitch and below for imaging and microdisplay applications. Proceedings of Electronic Components and Technology Conference ECTC, IEEE 66th, Las-Vegas (USA), 31 May - 03 Juin p. 362-367, 2016
V. Lumineau, F. Fournel, B. Imbert, F. Hodaj. Aluminum-germanium eutectic bonding for MEMS: behaviour and solidification of liquid Al-Ge on different substrates. Proccedings of the PRiME 2016 -Pacific Rim Meeting on Electrochemical and Solid State Science, Honolulu, Hawai (USA), 2-7 October 2016


